博通公司近日发布了一项创新技术——3.5D eXtreme Dimension系统级封装平台(XDSiP),这是业界首次推出3.5D Face2Face(F2F)封装技术,标志着行业技术的新突破。
3.5D XDSiP融合了2.5D技术和3D-IC集成F2F技术,打造出一款适用于消费类AI客户的新型多维芯片堆叠平台,助力开发下一代定制加速器(XPU)和计算ASIC。该技术不仅代表了系统级封装(SiP)解决方案的最高水平,也为大规模AI应用提供了强大支撑。
3.5D XDSiP平台的信号密度得到了显著提高,相较于F2B技术,其堆叠晶粒间的信号传输密度提升了7倍。这一创新不仅提高了数据传输效率,也为自定义计算的新时代奠定了基础。
在能效方面,3.5D XDSiP平台同样表现优异,采用3D HCB技术替代传统平面Die-to-Die PHY,将Die-to-Die接口功耗降低至原来的十分之一,展现了高效的能源利用率。
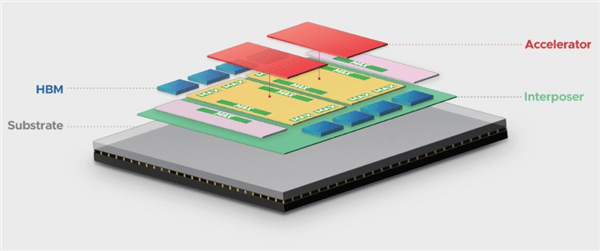
该平台还大幅降低了3D堆栈中计算、内存和I/O组件之间的延迟,进一步提升整体性能。同时,它支持更小的转接板和封装尺寸,降低了成本,有效解决了封装翘曲问题。
博通官方表示,目前已有6款基于3.5D XDSiP技术的产品正在研发中,预计最快将于2026年2月上市。这一消息为追求高性能AI解决方案的市场注入了新的期待。
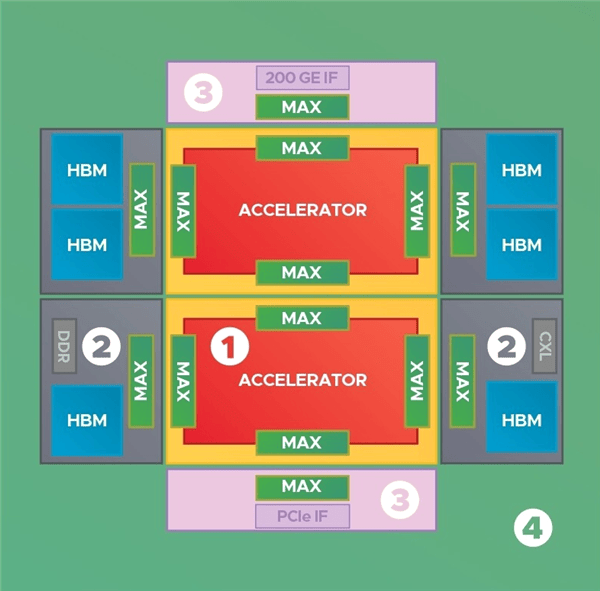






暂无评论